⇚ return
Photoelectric methods are used to determine the potential barrier heights at interfaces of various materials and other crucial electrical properties of nanoelectronic structures. This enables identification of energy levels and characteristic potentials allowing determination of complete energy band diagrams of investigated samples. For this purpose both the standard photoelectric methods and a package of original and precise in-house developed methods are used which allow, among others, extremely accurate determination of the effective contact potential difference in the MIS system. These methods are also used for mapping the parameter distributions over certain areas, such as the barrier height distribution over the gate area of a MIS structure.
Ellipsometry
We determine the optical properties of various materials (primarily semiconductors and dielectrics) and nanoelectronic structures by spectroscopic ellipsometry in the vacuum UV range. The spectral characteristics of the complex refractive index N(λ) and complex dielectric function ε(λ), where N=n+ik and ε=ε1+iε2, are estimated, as well as thicknesses of layers constituting nanostructures. For these purposes two spectroscopic ellipsometers are used:
- The Vacuum Spectroscopic Phase Modulated Ellipsometer (UVISEL VUV) of Horiba Jobin-Yvon S.A.S., operating in the light wavelength range λ=(142-880) nm, with the constant light incidence angle of 70°
- The Variable Angle Spectroscopic Ellipsometer (VASE) of J.A. Woollam Co. Inc., operating in the light wavelength range λ=(250-1700) nm and in the light incidence angle range from 15 to 84 degrees
Contact persons:
H.M. Przewłocki, hmp@ite.waw.pl
K. Piskorski, kpisk@ite.waw.pl
The offer of high tech services complex optical and photoelectric sample analysis
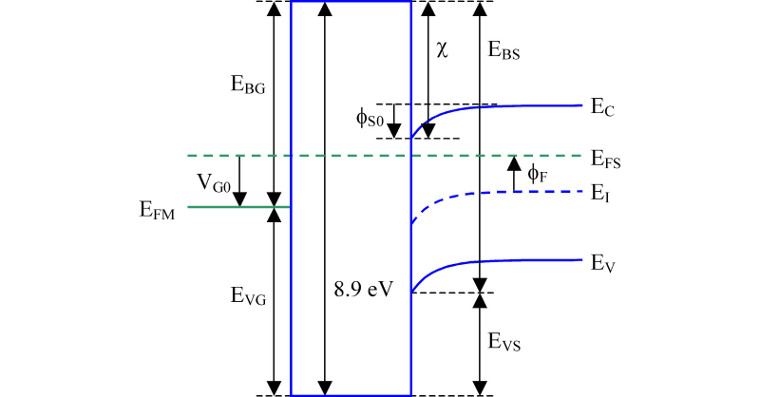
Photoelectric methods are used to determine the potential barrier heights at interfaces of various materials and other crucial electrical properties of nanoelectronic structures. This enables identification of energy levels and characteristic potentials allowing determination of complete energy band diagrams of investigated samples. For this purpose both the standard photoelectric methods and a package of original and precise in-house developed methods are used which allow, among others, extremely accurate determination of the effective contact potential difference in the MIS system. These methods are also used for mapping the parameter distributions over certain areas, such as the barrier height distribution over the gate area of a MIS structure.
Ellipsometry
We determine the optical properties of various materials (primarily semiconductors and dielectrics) and nanoelectronic structures by spectroscopic ellipsometry in the vacuum UV range. The spectral characteristics of the complex refractive index N(λ) and complex dielectric function ε(λ), where N=n+ik and ε=ε1+iε2, are estimated, as well as thicknesses of layers constituting nanostructures. For these purposes two spectroscopic ellipsometers are used:
- The Vacuum Spectroscopic Phase Modulated Ellipsometer (UVISEL VUV) of Horiba Jobin-Yvon S.A.S., operating in the light wavelength range λ=(142-880) nm, with the constant light incidence angle of 70°
- The Variable Angle Spectroscopic Ellipsometer (VASE) of J.A. Woollam Co. Inc., operating in the light wavelength range λ=(250-1700) nm and in the light incidence angle range from 15 to 84 degrees
Contact persons:
H.M. Przewłocki, hmp@ite.waw.pl
K. Piskorski, kpisk@ite.waw.pl

