Pomiar właściwości materiałow i struktur półprzewodnikowych metodami optycznymi
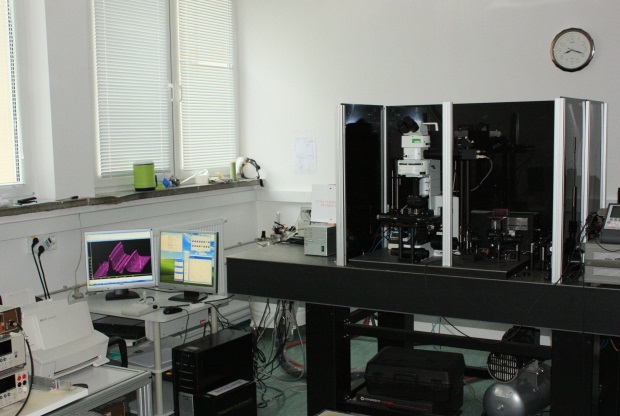
Do charakteryzacji materiałów i struktur stosowane są cztery metody optyczne: elipsometria spektroskopowa, spektrofotometria, mikrospektroskopia Ramana oraz interferometria.
Przy pomocy elipsometrii spektroskopowej mierzone są charakterystyki spektralne kątów elipsometrycznych ψ(λ) i Δ(λ) w celu określenia m. in. grubości warstwy t (szczególnie dielektryka), charakterystyk spektralnych zespolonego współczynnika załamania N(λ) i zespolonej funkcji dielektrycznej ε(λ), gdzie N = n + ik aε = ε1 + i ε2.
Dodatkowo spektrofotometria pozwala na pomiary spektroskopowe transmisji i odbicia w nadfiolecie, świetle widzialnym i bliskiej podczerwieni (UV-VIS-NIR) zarówno w roztworze, jak i ciele stałym.
Spektroskopia Ramana polega na analizie rozkładu i przemieszczenia linii widma Ramana, skąd można wyznaczyć rozkłady naprężeń mechanicznych w badanych próbkach oraz zidentyfikować niektóre cząsteczki chemiczne występujące w poszczególnych warstwach struktury (np. wytrącenia węglowe na powierzchni granicznej SiC-SiO2).
Badania interferometryczne, polegające na analizie rozkładu prążków interferencyjnych na powierzchniach różnych próbek, pozwalają m. in. na pomiar wysokości „stopni” (grubości warstw), ocenę płaskości i ewentualnego odkształcenia powierzchni próbki.
Dysponujemy laboratorium pomiarowym znajdującym się w klimatyzowanych pomieszczeniach z antyelektronstatyczną podłogą i specjalnie doprowadzonym uziemieniem, wyposażonym w zautomatyzowane i wysoko precyzyjne systemy pomiarowe: elipsometry spektroskopowe, spektrometr Ramana MonoVista i spektrofotometr na zakres UV-VIS-NIR.
WYNIK: Raport zawierający zmierzone zależności oraz obliczone parametry wraz z krótką charakterystyką próbek opracowany przez specjalistę.
WARUNKI TECHNICZNE (OGRANICZENIA): Ograniczeniem są rozmiary badanych próbek i możliwość umieszczenia ich w przyrządzie oraz rozmiar plamki w elipsometrze i spektrofotometrze. Warstwy metaliczne dla po- miarów elipsometrycznych nie powinny przekraczać 25 - 30 nm. W badaniach ramanowskich wzbudzenia dokonuje się za pomocą wiązki laserowej światłem widzialnym o długości fali 488 nm oraz w nadfiolecie z pomocą linii wzbudzającej 266 nm.
Pliki:
Z11_oferta_pom_opt.pdfNasza oferta obejmuje analizy materiałów i przyrządów przeprowadzone przy użyciu technik TEM, SEM i skaningowej mikroskopii jonowej oraz wykonanie mikro- i nanoprocesów przy użyciu techniki FIB w celu modyfikacji lub charakteryzacji materiałów i przyrządów.

