Pomiary parametrów struktury półprzewodnikowej metodami elektrycznymi i fotoelektrycznymi
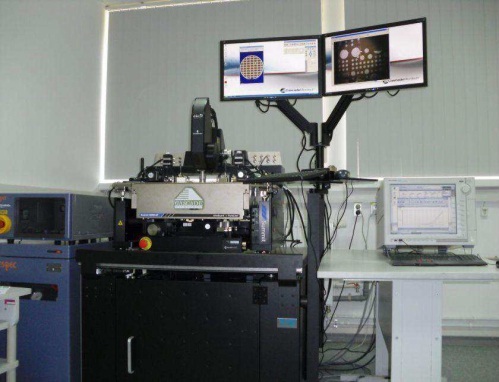
Stosując różne elektryczne metody pomiaru określa się dla różnych temperatur T i częstotliwości f następujące charakterystyki struktur: I-V, C-V, G-V, G/ω = f(ω,V) (spektroskopia admitancyjna). Na podstawie tych charakterystyk wyznacza się m. in. poziom i profil domieszkowania podłoża, napięcie wyprostowanych pasm VFB i napięcie progowe VT, rozkłady gęstości pułapek powierzchniowych Dit i pułapek brzegowych Nb oraz parametry pułapek (stała czasowa τ i przekrój czynny na wychwyt σ).
Pomiary oświetlonych charakterystyk I*-V, I*-λ, C*-V, C*-λ, u*-VG, u*-λ przy różnych mocach P światła i różnych średnicach strumienia światła pozwalają na określenie m. in. wartości efektywnej kontaktowej różnicy po- tencjałów ΦMS i jej rozkładu w płaszczyźnie powierzchni bramki ΦMS(x,y), napięcia wyprostowanych pasm VFB w półprzewodniku i jego rozkładu w płaszczyźnie powierzchni bramki VFB(x,y), napięcia wyprostowanych pasm VG0 w dielektryku i jego rozkładu w płaszczyźnie powierzchni bramki VG0(x,y), wysokości obu barier EBS i EBG oraz ich rozkładu w płaszczyźnie powierzchni bramki EBS(x,y) i EBG(x,y), szerokości przerwy zabronionej dielektryka EG i schematu pasmowego badanej struktury.
Dysponujemy laboratorium pomiarowym znajdującym się w klimatyzowanych pomieszczeniach z antyelektrostatyczną podłogą i specjalnie doprowadzonym uziemieniem, wyposażonym w zautomatyzowane i wysoko precyzyjne systemy pomiarowe, w tym analizator przyrządów półprzewodnikowych Agilent B1500 z proberem ostrzowym Summit 12000AB, miernik impedancji Agilent 4294A, systemy do pomiarów C-V, specjalizowane systemy własnej konstrukcji do pomiarów fotoelektrycznych, system do pomiarów metodą SLPT.
WYNIK: Raport zawierający zmierzone zależności oraz obliczone parametry wraz z krótką charakterystyką próbek opracowany przez specjalistę.
WARUNKI TECHNICZNE (OGRANICZENIA): Do pomiarów tranzystorów, kondensatorów MOS i diod Schottky’ego próbka powinna zawierać przyrządy testowe o pojemności maksymalnej nie większej niż CMAX =100 μF i minimalnej nie mniejszej niż CMIN = 1 pF, a także o rezystancji szeregowej nie większej niż 100 Ω. Dostępne są jednocześnie 4 zasilacze wymuszająco-pomiarowe. Do pomiarów fotoelektrycznych próbka powinna zawierać kondensatory MOS z częściowo przezroczystą bramką. Dla różnych materiałów wymagana grubość bramki może być różna, np. Al 15 - 40 nm.

